

更新日:2022/06/08
IOWNの実現に向けたメンブレン光変調器の開発NTT先端集積デバイス研究所
IOWNの実現に向けたメンブレン光変調器の開発
- シリコンフォトニクス
- 光インターコネクション
- 光変調器
IOWN(Innovative Optical and Wireless Network)構想で重要となる高速大容量な光ネットワークを低消費電力で実現するためにSi(シリコン)フォトニクス回路上に化合物半導体を異種材料集積したメンブレン光デバイスの研究開発を行っています。メンブレン光デバイスはコア層への高い光閉じ込めを実現できることから高効率な直接変調レーザや光変調器としての展開が期待されています。本稿で光変調器および光変調器とレーザの集積を中心に現在の研究開発の状況を紹介します。
開 達郎(ひらき たつろう)/相原 卓磨(あいはら たくま)
藤井 拓郎(ふじい たくろう)/武田 浩司(たけだ こうじ)
瀬川 徹(せがわ とおる)/松尾 慎治(まつお しんじ)
NTT先端集積デバイス研究所
光インターコネクションの進展とメンブレン光デバイス
光インターコネクションは、光ファイバの広帯域・低損失な特長から伝送容量が増大するほど、また伝送距離が長くなるほど電気を用いた情報通信より有利な技術であり、1980年代より長距離通信網において実用化されてきました。インターネットトラフィックの増大とともに、短距離においてもそのメリットが活かされ、現在ではボード間通信にも広く光インターコネクションが使われています。インターネットに接続されるデバイス数の増大、さらに個々のデバイスからの通信量の増大により、トラフィックの増大は今後も引き続くと考えられるため、すでに光インターコネクションが適用されている領域での大容量化と図1に示すようなさらなる短距離化、具体的にはボード内、チップ内光インターコネクションが今後の研究課題となります。これらの極短距離の光インターコネクションは、ルータやサーバなどの電子機器のスループットの向上に向けて今後重要になってくると考えられています。
これらの課題を解決するうえで前提条件として重要なのが、低消費電力化と低コスト化です。低消費電力化に向けては小さな電力で高速に光デバイスを変調することが重要となりますが、そのためにはコア層*1の光閉じ込め係数*2を極力大きくすることが必要です。低コスト化に向けては、光デバイスの場合、モジュール化コストの占める割合が大きいことから光集積回路化により複数の送受信素子と光フィルタなどの機能素子を一体集積し、アセンブリコストを削減することにより大幅な低コスト化が期待されています。この際、Si(シリコン)電子回路で用いられる微細加工技術を利用して低損失な光導波路や高性能な光回路を作製できるSiフォトニクス技術を利用することが重要となります。一方で、Siではレーザや高効率な光変調器が作製できないため、大規模集積化に向けては化合物半導体であるInP(インジウムリン)系化合物半導体を用いた光デバイスの異種材料集積方法が課題となっています。
本稿では、私たちが検討を行っているSi基板上のメンブレン光デバイスについて説明します。メンブレン光デバイスとは低屈折材料上に作製した薄膜光デバイスであり、私たちは、典型的には250nm程度の膜厚のInP系化合物半導体を用いたレーザや変調器をSiO2(二酸化ケイ素)/Si基板上に作製しています。デバイスの上下を低屈折率なSiO2や空気で挟むことによりコア層の高い光閉じ込めを得ることができ、高い変調効率の直接変調レーザ (1)(2)(3)(4)(5) や光変調器が作製可能となります。本稿では、光変調器について詳細に述べていきます。
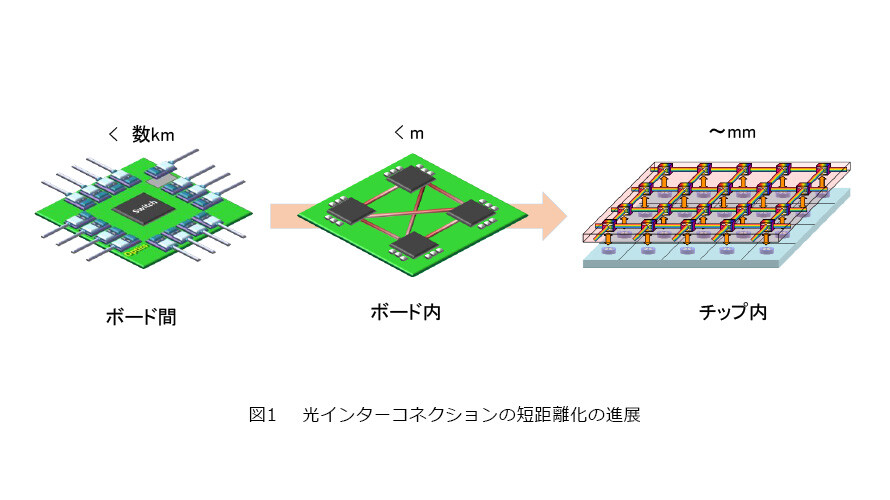
メンブレン光変調器
光変調器は、屈折率を主に変調する位相変調器と吸収係数を変調する強度変調器の2種類に分類できます。位相変調器はマッハツェンダ干渉計と組み合わせたマッハツェンダ(MZ)変調器として用いられ、複数のMZ変調器を組み合わせて、位相、強度、偏波を変調することにより一波長に対して1Tbit/sを超えるような大容量化と長距離伝送が特長です。代表的な使用材料はLiNbO3(ニオブ酸リチウム)、Si、InP系化合物半導体が挙げられます。トラフィックの増大から将来的にはデータセンタ内のような2km以下の短距離でも利用が必要になってくると考えられますが、その際には、素子サイズを小さくして大規模集積した低コスト化が重要となります。そのためにはLiNbO3、Siと比較して一桁程度効率の良いInP系化合物半導体がキーデバイスと考えられます。
一方、強度変調器として代表的な材料はInP系化合物半導体とGeSi(ゲルマニウムシリコン)が用いられています。強度変調器は強度変化のみを信号として用いるためMZ変調器と比較すると一般的には伝送容量は小さくなりますが、構成がシンプルかつコンパクトであるため、より短い距離で大量の送信素子が必要となるときには重要となります。データセンタで用いられる1.3ミクロン帯での利用を考えると、現状ではGeSiは成長に課題があり、InP系化合物半導体が有利となります。
図2(a)はSiマッハツェンダ干渉計とInP位相変調器を用いたMZ変調器とメンブレンレーザを異種材料集積した光集積回路の構成を示しています (6) 。Siフォトニクス技術の特長であるSSC(スポットサイズ変換器)*3を集積することにより、レンズを用いることなくデバイスを光ファイバと直接密着させることにより高効率にファイバとのアセンブリが可能となります。図2(b)および(c)はメンブレンレーザ、メンブレン位相変調器の断面構造です。変調器のバイアス用のレーザは連続光で高出力と安定したシングルモード性が求められるため、レーザコア層への光閉じ込めを小さくすることが重要となります。そのため、レーザコア層の下にSi導波路を配置しています。メンブレレーザ構造の等価屈折率がSi導波路と同程度であるため、Si導波路の幅を調整することでレーザコア層への光閉じ込め係数を調整できます。一方、位相変調器では、Si導波路はなくして閉じ込め係数を最大化できるようにしています。このように、Si導波路とメンブレン光デバイス間で光の閉じ込めを自由に設計できることも、メンブレン光デバイスの特長です。
*3 SSC:通常、幅0.5ミクロン程度のSi導波路の先端を0.2ミクロン程度まで細くすることにより光をSi導波路の外に漏らし、外側に作製したSiOxなどのSiO2よりわずかに屈折率の高い第2コアに光を閉じ込める構造により、光のスポットの大きさをSi導波路からSiOx導波路の大きさに変換する素子。これにより光ファイバとのスポットサイズの違いを吸収しレンズなしで高効率な光結合が可能となります。
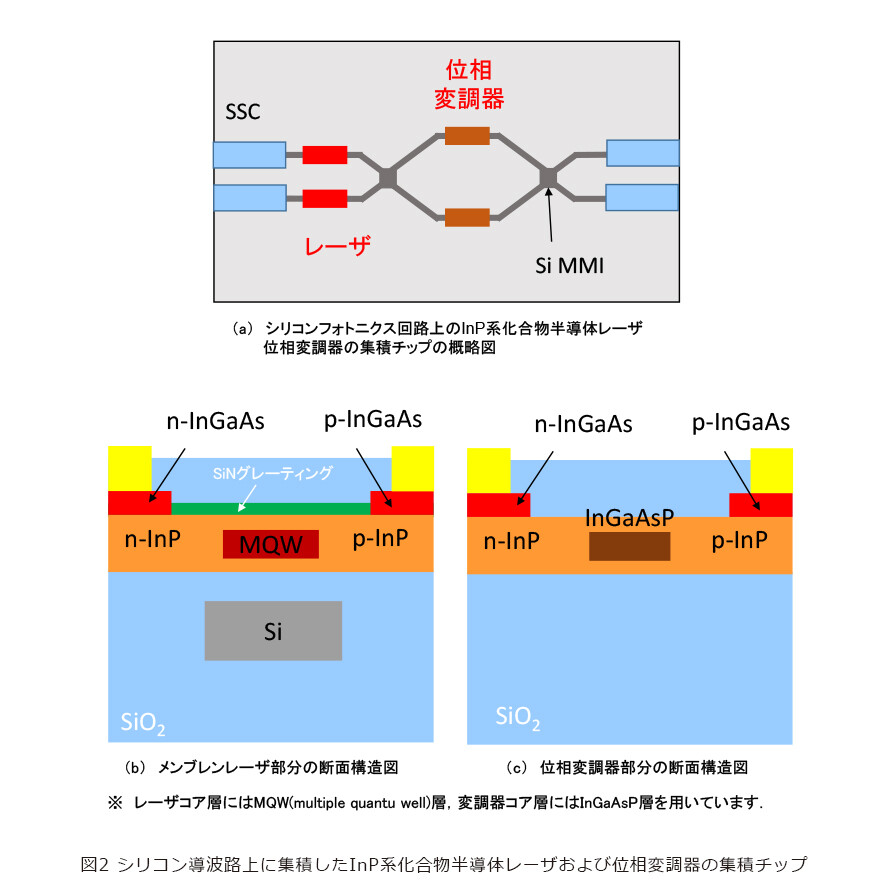
メンブレンMZ変調器とレーザの光集積回路の作製工程を図3に示します。作製手順は次のようになります。①SOI(Si on Insulator)基板を用いてSi導波路を作製し、導波路全体をSiO2で覆った後にCMP(Chemical Mechanical Polish)を用いて平坦化、InP基板上に成長したレーザのコア層になるMQW(Multiple quantum well)層を平坦化したSiO2上に直接接合します。②レーザコア層となる部分を除いてMQW層を選択エッチングにより除去し、InP層を露出させます。③再成長によりInP薄膜上に位相変調器のコア層になるn型InGaAsP(インジウムガリウムヒ素リン)層を成長させます。④レーザ、および位相変調器のコアとなる部分を除きInP層まで選択エッチングにより除去します。⑤再成長により各コア層をドーピングしていないInP層で埋め込みます。⑥選択的ドーピングを行いn層、p層を形成します。⑦レーザ、位相変調器を分離し、レーザ領域にはグレーティングを形成します。⑧最後にSSCおよび電極を形成します。提案する作製方法の特長はSi基板上で化合物半導体の再成長を行うことです。メンブレン光デバイスの総膜厚が230nm程度と薄膜のため、SiとInP系半導体の熱膨張係数差に伴う歪に対して耐性を持つことにより、Si基板上での再成長が可能となります。これにより、レーザ活性層と位相変調器層などの異なるバンドギャップを持つInP系半導体を一度に作製可能になります、また、コア層形成時の位置合わせにSi基板上のステッパー用マーカーを使用するため、Si導波路とメンブレン光デバイスのコア層をステッパーの位置合わせ精度で集積可能、という特長を持ちます。
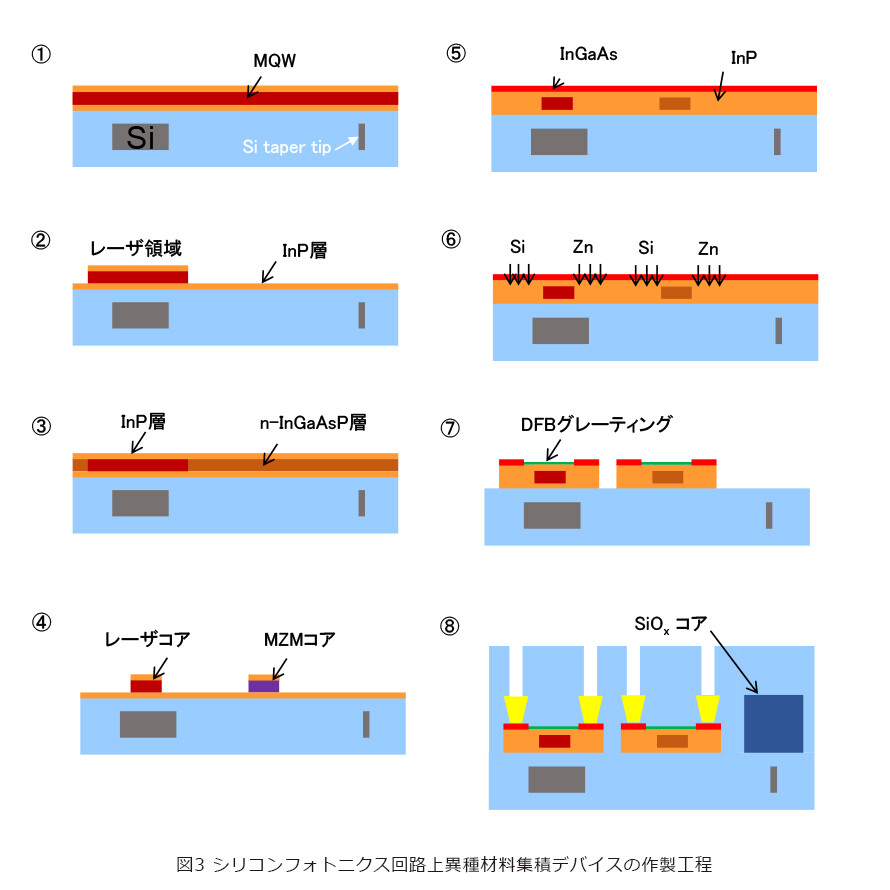
作製したデバイスの特性を図4に示します。レーザ活性層および位相変調器のコア層の長さは500ミクロンとしました。Siフォトニクスで用いられるSi位相変調器では数mmの長さを持つこと、また、レーザ集積できていることから大幅な小型化が実現されました。図4(a)はMZ光変調器をオフ状態に設定したときの出力光強度の電流依存性を示しています。測定温度25℃と80℃においてレンズ付きファイバで受光した場合の結果を示しています。ファイバを直接結合させて受光することも可能ですが、今回は実験の簡略化のためにレンズ付きファイバを用いました。この場合、素子端面で反射が起こるため、図に示されるようにモードホッピングが生じています。しきい値電流は25℃で約6mA、80℃で約8mAでした。25℃ではレンズ付きファイバで最大2mW、80℃では1mWの出力を得ました。なお、ファイバ結合損失は3dBでした。図4(b)は25℃と80℃で、それぞれバイアス電流76.0 mA、50.6mAでの発振スペクトルを示しています。シングルモード発振が得られており、80℃のときの横モード抑圧比は59dBと良好な値を得ました。図4(c)、(d)は50-Gbit/s NRZ(Non Return to Zero)信号で変調した場合のMZ変調器の動特性を動作温度25℃と80℃の場合で示しています。片側の位相変調器にピーク電圧2.5Vの電気信号を入力し、50オーム終端しています。消光比は3dB程度と低いもののどちらの温度でも明瞭なアイ開口を確認しました。消光比に関しては、差動動作させ、もう片方の位相変調器にも反転した信号を印加することなどで改善することが可能です。また、位相変調器の電極は集中定数電極を用いコア層は500ミクロンと比較的長いのですが、メンブレン構造の低容量のおかげで50-Gbit/s NRZ信号でも動作しています。
次に、InP系半導体を用いた強度変調器について述べます (7) 。強度変調器としては電界吸収型変調器(EAM)が用いられますが、これは動作波長付近にバンドギャップを持つ半導体に電界を印加することにより、バンドギャップが長波長側にシフトして吸収係数が変化する現象を用いています。吸収量を直接変化させるためMZ変調器のように干渉計を用いる必要がなく非常にシンプルな構成となります。そのため、InP基板上のEAMは通常100〜300ミクロン程度のコア層の長さでレーザと集積されデータセンタ内で広く用いられています。しかし、InP基板上EAMは素子容量により動作速度が制限されており、高速化のためには50オーム終端を用いることや、さらには進行波型電極の適用が必要となりますが、アレイ化してコンパクトな光集積回路の作製や低消費電力化には課題が残ります。そこで、低容量なメンブレン構造を用いたEAMが注目されています。構造は位相変調器と同様にコア層への光閉じ込め係数を大きくすることが重要であることから、EAMコア層の直下にはSi導波路は置かない構造で素子を作製しました。コア層にはフォトルミネッセンスピークが1230nmの9層MQWを用いました。動作波長を1280nmとした場合の透過率の電圧依存性を図5(a)に示します。コア層長が200ミクロンの素子の場合、バイアス電圧が0から3Vまで変化させることにより8.5dBの消光比が得られることが分かります。ファイバ結合損を除いたEAMの挿入損失はSi導波路との比較から3dBと見積もられます。図5(b)は小信号応答特性を示しています。動作波長は1280nm、バイアス電圧を2Vと設定しました。この実験では50オーム終端を用いていません。図より3dB帯域は59GHzとなります。
次に100-Gbit/s NRZ信号でのアイ波形を測定しました。図5(c)、(d)はそれぞれ入力電気信号、光出力信号です。EAMのバイアス電圧は1.2Vとしました。パルスパターン発生器からのピーク電圧0.12Vの電気信号を電気線形アンプ22dBで増幅し50オーム終端していないEAMに印加しました。入力電気波形と比較して遜色ないアイ波形が得られており、消光比としては4.6dBが得られました。MZ変調器と同様の作製工程でレーザ集積も可能なため、ボード内などのより短い距離の光インターコネクションへの適用が期待されます。

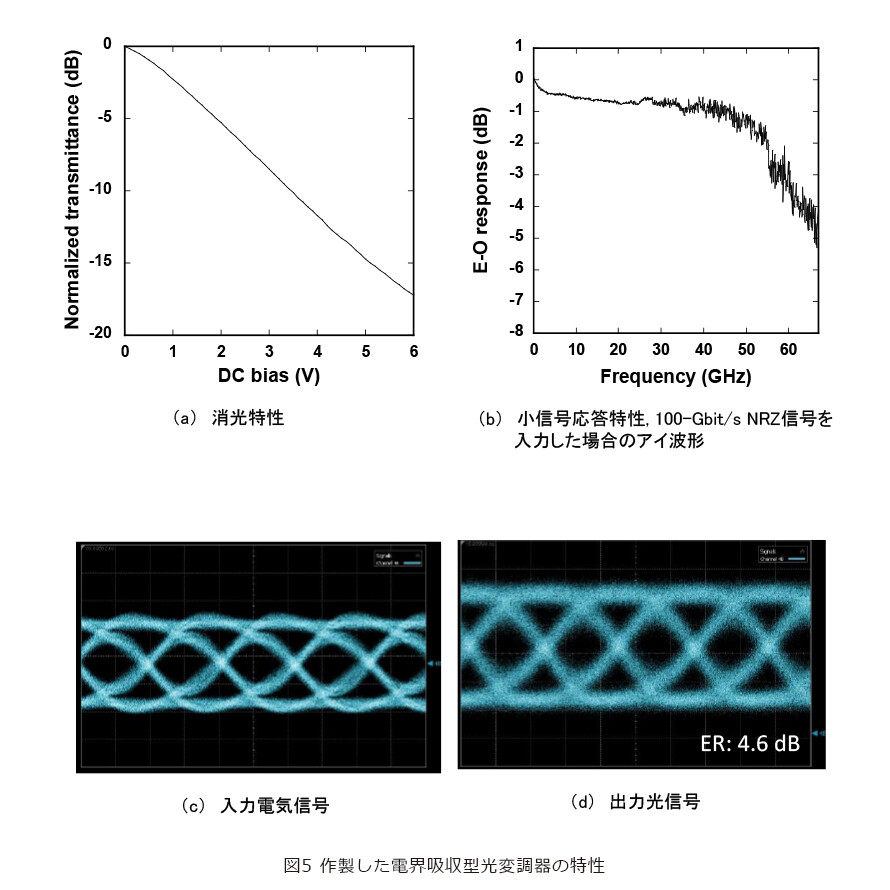
今後の展開
メンブレン光変調器は、高い光閉じ込め係数と低容量化という2つの特長から高速で低消費電力な変調器の作製に適していることを述べました。これらに加え、SSCが集積されていることからファイバアレイ等との結合も容易になります。また、Si回路上に集積できていることから、波長多重技術を適用するときにSi導波路で作製した合波回路との集積も可能です。したがって、高密度に光デバイスを集積化し、単位長さ当りのスループットを最大化させることが重要な距離の短い光インターコネクションのキーデバイスとして期待されます。
■参考文献
- (1) 武田・藤井・岸・鹿間・脇田・西・佐藤・土澤・瀬川・佐藤・松尾: “高密度・低消費電力な短距離光インター コネクションに向けたデバイス技術,” NTT技術ジャーナル, Vol.32,No.8,pp.15-22,2020.
- (2)T. Fujii, K. Takeda, N-P. Diamantopoulos, E. Kanno, K. Hasebe, H. Nishi, R. Nakao,T. Kakitsuka, and S. Matsuo:“Heterogeneously Integrated Membrane Lasers on Si Substrate for Low Operating Energy Optical Links,”IEEE Journal of Selected Topics in Quantum Electronics, Vol. 24. No.1, 1500408, 2016.
- (3)T. Fujii, K. Takeda, N-P. Diamantopoulos, E. Kanno, K. Hasebe, H. Nishi, R. Nakao,T. Kakitsuka, and S. Matsuo:“Heterogeneously Integrated Membrane Lasers on Si Substrate for Low Operating Energy Optical Links,”IEEE Journal of Selected Topics in Quantum Electronics, Vol. 24. No.1, 1500408, 2016.
- (4)T. Fujii, K. Takeda, N-P. Diamantopoulos, E. Kanno, K. Hasebe, H. Nishi, R. Nakao,T. Kakitsuka, and S. Matsuo:“Heterogeneously Integrated Membrane Lasers on Si Substrate for Low Operating Energy Optical Links,”IEEE Journal of Selected Topics in Quantum Electronics, Vol. 24. No.1, 1500408, 2016.
- (5)K. Takeda, T. Sato, A. Shinya, K. Nozaki, W. Kobayashi, H. Taniyama, M. Notomi, K. Hasebe, T. Kakitsuka, and S. Matsuo:“Few-fJ/bit data transmissions using directly modulated lambda-scale embedded active region photonic-crystal lasers,” Nature Photonics, Vol. 7, pp. 569 – 575, 2013.
- (6)T. Hiraki, T. Aihara, T. Fujii, K. Takeda, Y. Maeda, T. Kakitsuka, T. Tsuchizawa, and S. Matsuo: “Integration of a high-efficiency Mach-Zehnder modulator with a DFB laser using membrane InP-based devices on a Si photonics platform,” Optics Express,Vol.29, pp. 2431-2441,2021.
- (7)T. Aihara, T. Hiraki, Y. Maeda, T. Fujii, T. Tsuchizawa, K. Takahata, T. Kakitsuka, and S.Matsuo: “60-GHz-bandwidth O-band Membrane InGaAlAs Electro-Absorption Modulator on Si Platform,”GFP 2021, Malaga, Spain, Dec. 2021. DOI: 10.1109/GFP51802.2021.9674001.

IOWNの実現に向け今後ともメンブレン光デバイスの研究開発を続けていきます。