先端デバイス研究部
レジストの薄膜化は、パターンアスペクト比を緩和し、解像性を向上させるために有効である。しかし、高分子膜であるレジスト膜を100nm程度以下にまで薄膜化した場合、従来の厚い膜と異なり、表面や界面の影響をより反映した膜性能を発現することが予測される。その場合、解像性を決める主要因であるラフネスへも影響が現れる可能性があり、実用上その理解が重要となる。そこで我々は、レジストの薄膜化に伴うレジスト特性の定量的な解析を試み、薄膜化がラフネスおよびレジストの内部組織に与える影響を明らかにした[1]。
電子線ポジ型レジスト(ZEP520)を使用し、膜厚10、30、100nmについて検討した。ラフネスは、ラインパターン(設計線幅50 nm)の幅揺らぎを評価することにより比較した。図1に示すように、レジスト膜厚の減少とともにパターン幅揺らぎ値が増大することが分かった。特に30
nmより薄くなると、その傾向は顕著になった。この増大の原因について考察するため、レジスト内部の組織構造である高分子集合体に着目し、薄膜化の影響について検討した。その例を図2に示す。高分子集合体の断面形状を比較すると、膜厚の減少に伴い、ほぼ円形から歪んだ楕円状へと変化することが分かった。また、体積も減少した。このような内部組織構造の変化は、現像液に対するレジストの溶解性にも現れ、薄膜化によって溶解性は増加した。これは、薄膜化に伴う組織構造変化により、主として高分子集合体の周囲部分の溶解性が増すことを示すものである。このことから、薄膜化によって高分子集合体と周囲部分との溶解コントラストが増大し、ラフネスが増加したと考えられる。超薄膜レジストでは、分子レベルのラフネスが増大することが明らかとなり、レジスト内部の組織構造制御が重要になる。
[1] K. Kanzaki et al., Jpn. J. Appl. Phys. 41 (2002) L1342.
 |
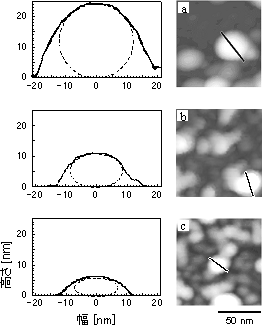 |
||||
|
|